佑光智能共晶機大幅度降低空洞缺陷
在半導(dǎo)體封裝領(lǐng)域,空洞缺陷長期困擾生產(chǎn)效率與產(chǎn)品可靠性。空洞形成于焊接環(huán)節(jié),主要由焊料氧化、氣體釋放及工藝參數(shù)波動導(dǎo)致,直接影響焊點的機械強度與電氣性能。佑光智能半導(dǎo)體科技(深圳)有限公司針對這一關(guān)鍵問題,通過技術(shù)創(chuàng)新實現(xiàn)共晶工藝的突破性進展。
公司研發(fā)的雙工位共晶加熱臺技術(shù),通過單獨溫控模塊與并行操作設(shè)計,優(yōu)化了焊接熱環(huán)境連續(xù)性。該結(jié)構(gòu)在提升產(chǎn)能的同時,準(zhǔn)確控制溫度曲線,抑制焊料揮發(fā)氣體滯留,從源頭減少宏觀空洞與微孔空洞。實時監(jiān)控系統(tǒng)配備高分辨率成像組件,可動態(tài)捕捉共晶過程細(xì)節(jié)。操作人員依據(jù)畫面反饋即時調(diào)整參數(shù),確保氣體充分排出,避免因間隙殘留形成平面微空洞。脈沖加熱技術(shù)的引入進一步縮短高溫暴露時間,降低材料熱應(yīng)力,有效抑制收縮空洞與基爾肯達爾空洞。
工藝創(chuàng)新之外,角度校準(zhǔn)鏡筒解決了位置偏移引發(fā)的焊接不均問題。該組件基于光學(xué)成像與算法協(xié)同,使芯片與基板貼合精度達到微米級,消除因貼合不良導(dǎo)致的氣體滯留。實際應(yīng)用數(shù)據(jù)顯示,此類技術(shù)組合使設(shè)備在光通訊器件封裝中實現(xiàn)每小時1000件的穩(wěn)定產(chǎn)出,且碰撞防護機制將意外斷電導(dǎo)致的缺陷風(fēng)險降低超80%。
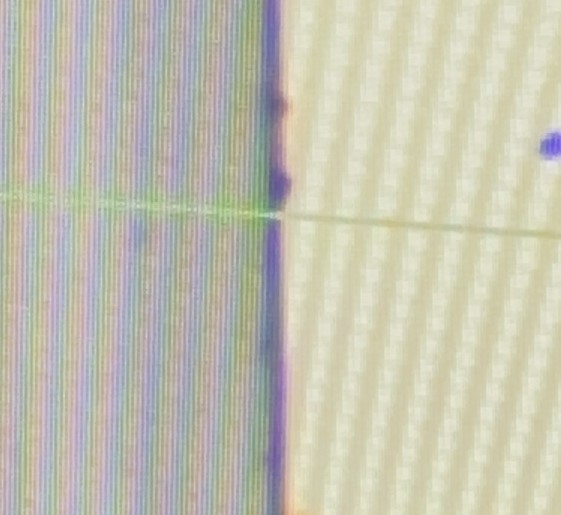
行業(yè)趨勢顯示,封裝技術(shù)正向高集成度與智能化演進。異構(gòu)集成需求推動設(shè)備精度提升,而人工智能正逐步滲透工藝優(yōu)化環(huán)節(jié)。佑光智能的共晶機已集成機器學(xué)習(xí)模塊,通過歷史數(shù)據(jù)分析自動優(yōu)化溫度曲線與焊接時長,形成閉環(huán)控制。此舉不僅適配當(dāng)前5G光模塊的微型化需求,更為未來3D IC堆疊封裝預(yù)留技術(shù)接口。
國際頭部企業(yè)通過材料與工藝協(xié)同控制空洞率,如引入同位化學(xué)刻蝕與多步沉積-刻蝕集成工藝。佑光智能的解決方案與之形成互補:硬件端以雙工位設(shè)計與脈沖加熱保障工藝穩(wěn)定性,軟件端依托實時監(jiān)控與AI算法實現(xiàn)動態(tài)糾偏。第三方測試表明,該方案將焊點空洞率控制在行業(yè)基準(zhǔn)線的30%以下,尤其對直徑25-50微米的平面微空洞改善效果突出。
隨著玻璃基板等新材料在封裝領(lǐng)域應(yīng)用加速,設(shè)備需同步適應(yīng)更高散熱與信號傳輸要求。佑光智能的技術(shù)路徑將持續(xù)聚焦熱管理精度與界面控制能力,以共晶工藝革新推動半導(dǎo)體封裝可靠性的系統(tǒng)性提升。


